1. Reflow Process condition use Sn-Ag-Cu
Dengan menganggap bahwa melting point Alloy Sn-Ag-Cu adalah 217 ~ 220 oC, agar temperaturenya merata ke seluruh komponen di PCB, maka temperature di setting ke 220oC agar solder masih dalam kondisi cair selama kira2 30 sec. Contoh temperature profile adalah spt gambar dibawah.
2. Sifat mounting dari Sn-Ag-Cu
a. Kondisi kemampuan reflow soldering pada ruang udara
Solder Sn-Ag-Cu di evaluasi ketika digunakan pada lead plating Sn90Pb10 dan Sn98Pb2. Dalam solderability (wetting characteristic ) kedua jenis plating hasilnya sama dan tisak ada permasalahan praktis dalam kemampuan inspeksi.
b. Kondisi dari area yang tersolder
Pada saat proses soldering dengan menggunakan Sn-Ag-Cu, intermetallic compound layer ( CuSn layer ) terbentuk disekitar land.Hal ini sama persis yang terjadi pada Sn63 Pb37 solder. Hal ini membuktikan sebuah ikatan solder yang bagus telah terbentuk. Selain itu composisi microstructure AgSn juga terlihat pada area yang tersolder. Komposisi microstructure ini tidak akan rusak pada temperature yang tinggi dan structurenya akan memperkuat sifat mekanisnya. Jadi inilah bahan yang tepat untuk meningkatkan reliabilitas solder.
c. Evaluasi Bonding strength
Kelelahan thermal pada area yang tersolder akan dievaluasi dalam 3 solder alloy: Sn-Ag-Cu, Sn63Pb37 dan Sn-Ag-Cu-Bi solder sebagai refferensi. Temperature cycle test diberlakukan kemudian dilanjutkan dengan bonding strength test.
Hasilnya adalah Bonding strength Sn-Ag-Cu solder pada pin QFP yang tersolder lebih besar dari Sn63Pb37 atau Sn-Ag-Cu-Bi. Jadi Sn-Ag-Cu performance mempunyai reliability bonding yang sesuai dengan yang diharapkan.
d. Kondisi bonding strength setelah temperature cycle test
Hasil evaluasi membuktikan bahwa Sn63Pb37 solder lebih cenderung untuk crack dibandingkan Sn-Ag-Cu solder. Tidak ada perubahan yang besar dari microstructure Sn-Ag-Cu setelah temperature cycle test.
Jadi Sn-Ag-Cu solder mempunyai kemampuan lebih tinggi dalam kekuatan kelelahan mekanis dibandingkan Sn63Pb37.
3. Sifat mounting dari berbagai komposisi alloy Sn-Ag-Cu
Berikut adalah hasil evaluasi karakteristik Sn-Ag-Cu karena perbedaan jumlah Ag dan Cu.
a. Kemampuan reflow soldering dari berbagai type Sn-Ag-Cu
Hasil evaluasi membuktikan bahwa wettability solder sama dalam berbagai komposisi Sn-Ag-Cu. Artinya adalah segala komposisi Sn-Ag-Cu menghasilkan solder dengan wettability yang bagus.
b. Evaluasi bonding strength
Dengan komposisi yang berbeda, reliability bonding strength dievaluasi. Hasil dari evaluasi ini membuktikan bahwa bonding strength Sn-Ag-Cu lebih besar atau sama dengan bonding strength Sn63Pb37 setelah temperature cycle test.
4. Karakteristik mounting Sn-AG-Cu pada berbagai temperature reflow
Hasil evaluasi membuktikan bahwa wettability solder tidak berubah secara signifikan dengan adanya perubahan temperature reflow. Demikian juga bonding strength sangat bagus walaupun temperature reflow berubah ubah.
5. Penggunaan temperature reflow pada manufacturing
Variasi temperature pada PCB harus dijaga dibawah +/- 10oC. Hasil pemeriksaan pada PCB berbagai posisi didapatkan bahwa beda max reflow adalah 15oC.
6. Control temperature reflow dan dipp solder
Jika PCB mengalami process reflow dan kemudian dilanjutkan dengan dipp solder, lifting lead atau crack atau remelting bisa terjadi. Pada saat reflow, terbentuk alloy layer yang mempunyai melting point lebih rendah dari Sn-Ag-Cu solder.
Pada saat dipp solder, alloy layer tadi mengalami kontak langsung atau tidak langsung dengan wave solder. Sehingga dengan melting point yang lebih rendah dari Sn-Ag-Cu, maka beberapa bagian dari area yang tersolder selama reflow mengalami re-melting.
Dari hasil evaluasi, didapatkan bahwa remelting bisa dicegah apabila temperaturenya dibawah 150 oC.
7. Reliability solder joint pada Array Package ( BGA , CSP Chip scale Package )
Temperature cycleing dilakukan selama reliability test yang dipercepat. Hasil pengujian dimasukkan pada Coffin mansion model, sebuah formula yang sering digunakan untuk mendapatkan lifetime kelelahan thermal dari solder joint da untuk menghitung reliability solder joint. Hasil evaluasi menunjukkan bahwa reliability Sn-Ag-Cu adalah sama tau lebih bagus dari Sn63Pb37.
Diperkirakan bahwa reliability dan lifetime solder joint untuk Sn63Pb27 adalah 12 tahun sedangkan pada Sn-Ag-Cu diperkirakan sekitar 14 tahun.












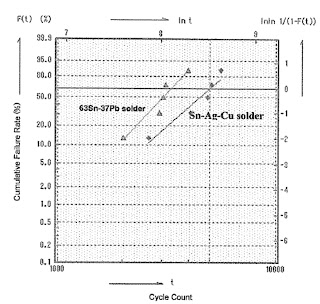

Tidak ada komentar:
Posting Komentar
Silakan masukkan komentar anda: